适用于功率 MOS 晶圆级老化测试的解决方案
原因
产品展示
“`
Microtest 的 Hatina WLBI 是一款坚固的晶圆级老化测试和 HTOL(高温工作寿命)解决方案,专为晶圆上的功率器件而设计。这款紧凑型测试腔体(560×560×550 mm)可连接到标准的晶圆探针台,无需对现有设备进行大范围改造,即可实现整片晶圆的老化测试。
其高并行吞吐量可同时支持多达 1,600 个测试点,每个测试点的工作电压高达 1.2 kV,电流高达 2 mA,是进行功率技术器件寿命和可靠性测试的理想选择。
WLBI 可无缝集成功能性老化、HTGB(高温栅极偏置)和 HTRB(高温反向偏置)测试设置,提供灵活且经济高效的封装。
WLBI 结构紧凑且易于操作,专为洁净室使用而设计,并秉承了 Microtest 的无烤箱老化理念——将加热器直接嵌入到每个被测器件(DUT)处,以实现精确、低功耗的热控制。
这种设计降低了能耗和占地面积,并简化了自动化兼容性。
总而言之,Hatina WLBI 是一个高密度、晶圆级的老化平台,可为先进的功率半导体提供整片晶圆的可靠性测试。它将高电压、严密温控和多点可扩展性集于紧凑、易于集成的格式中,是提高制造效率和增强器件信心的完美选择。
“`
特征

Hatina WLBI
Number of test sites
Up to 1600
Dimensions
D⨯W⨯H
560 mm ⨯ 560 mm ⨯ 560 mm
Analog/Power
Drain High Voltage Power Supply
-50V to 1.2KV
Gate Voltage Power Supply
-50 /50V
Current for device during Functional test
2mA
Current for device during HTRB test
2mA
Current for device during HTGB test
2mA
Hatina WLBI Datasheet
应用领域
画廊

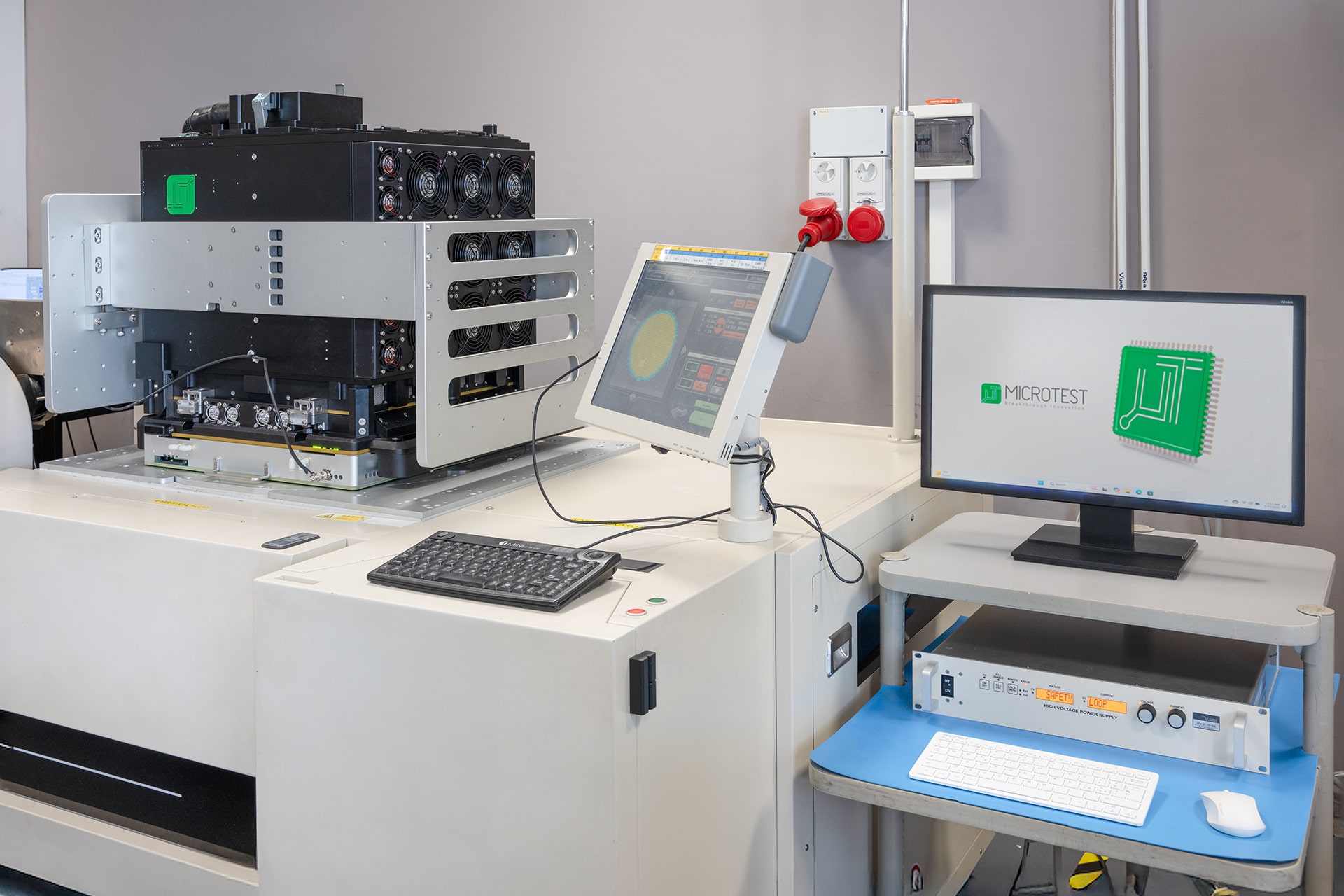

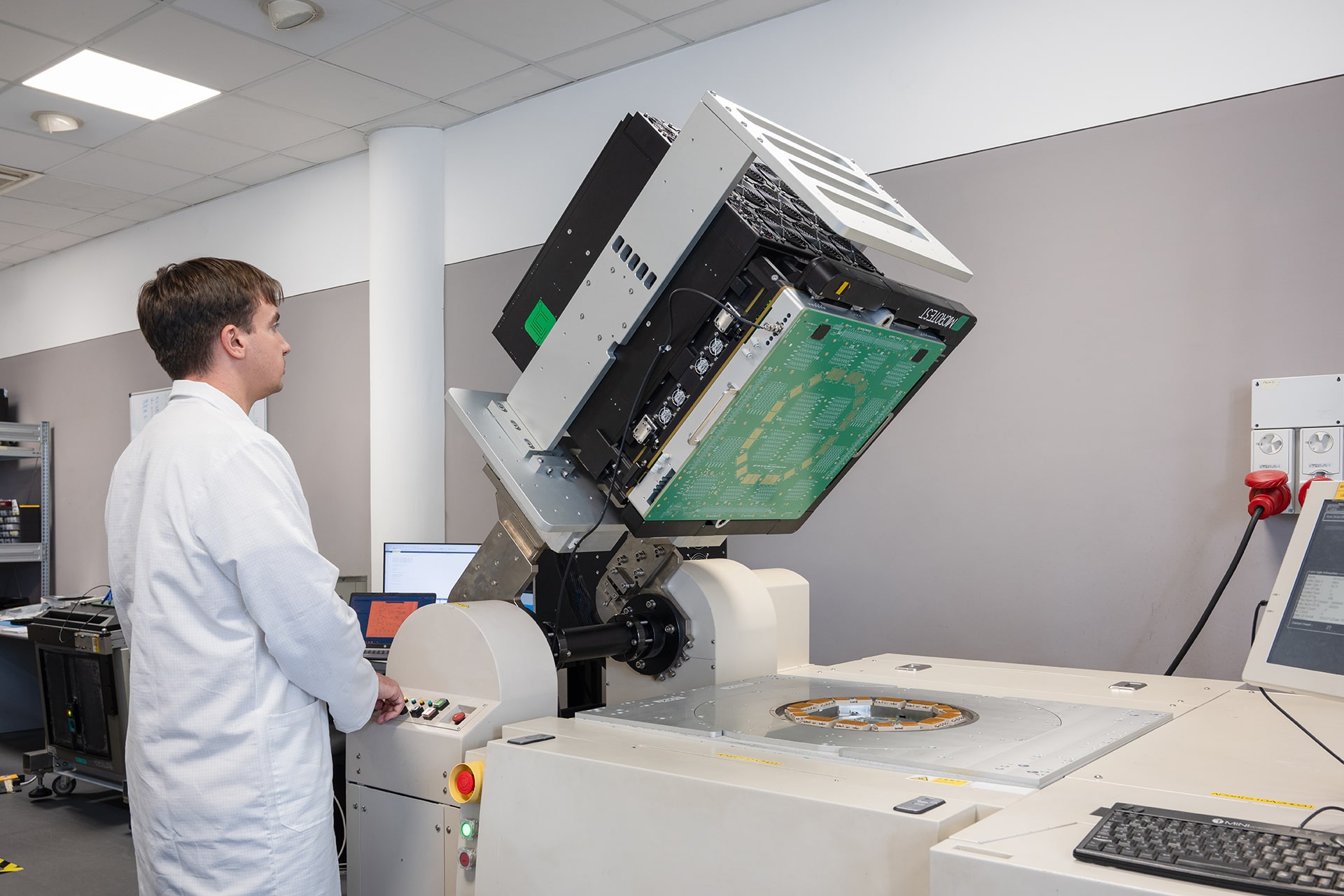
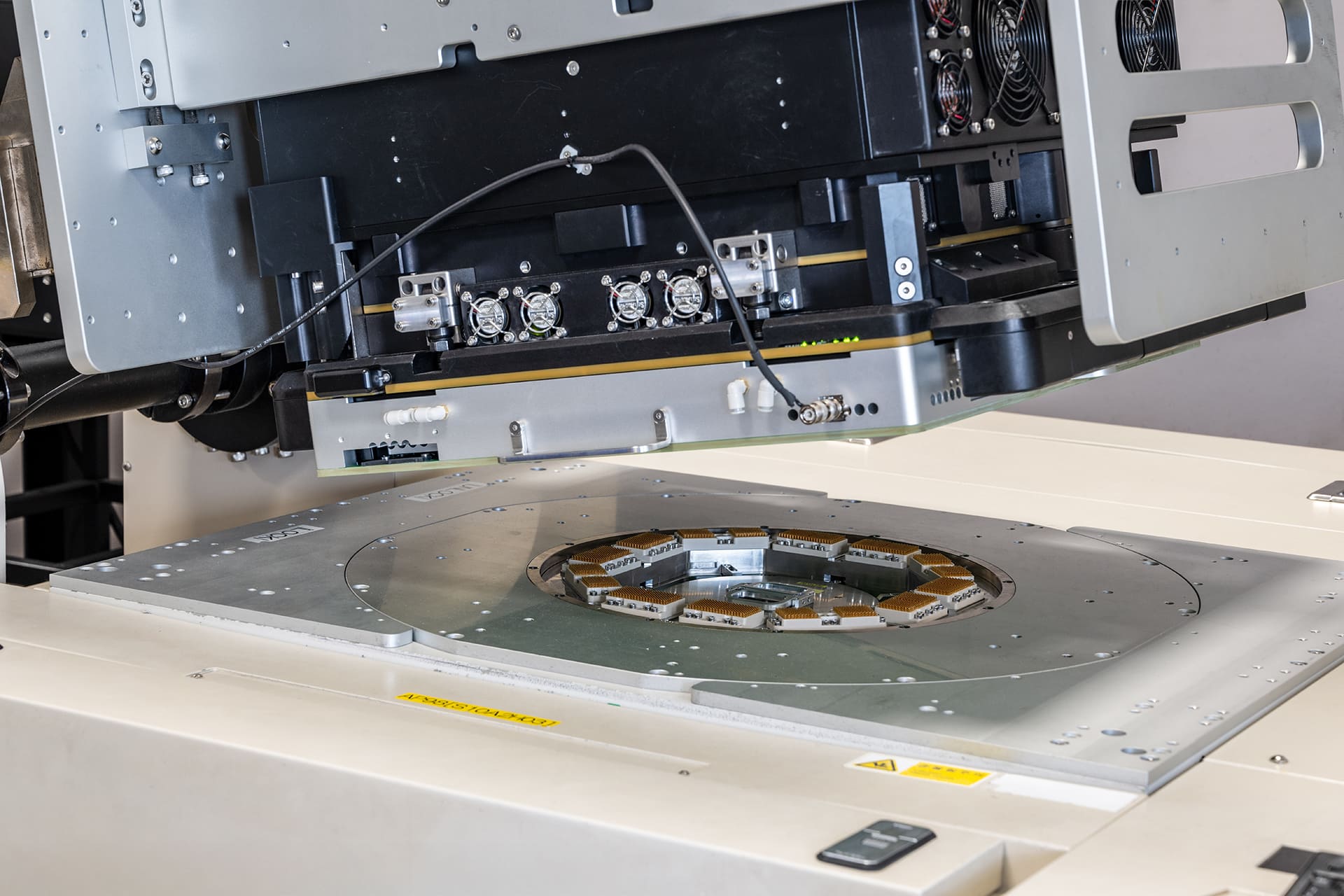
了解更多








